如何解决BGA锡球的HIP(Head-In-Pillow)虚焊问题
BGA封装IC在焊接过程容易发生HIP缺点已经是个不争的事实,而且尺寸越大越容易发生,这(Head-In-Pillow,枕头效应)的双球虚焊真的是个相当讨人厌的问题,因为不论是使用X-Ray、电测(FVT或ICT),甚至把产品送去烧机(B/I)都不一定可以100%的侦测出有HIP的问题来。所以产品卖出去后,偶尔就会有BGA焊接的不良品反馈回来。
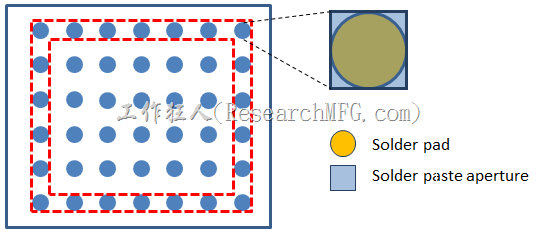
那到底有没有办法可以解决或降低BGA锡球焊接时的HIP(Head-In-Pillow)虚焊问题呢?
答案不能说没有,但也不敢说可以100%解决HIP的问题,因为HIP的问题牵涉到IC载板、组装电路板、回焊炉温、产品设计…等等相关问题,很难说可以一次全部解决,下面工作熊试着提供一些方法给大家参考:
减缓Reflow升温的速度,以降低板材变形量
不论是IC载板或是组装的电路板(PCB),当电路板上出现温度上升分布不均时将引起局部应力分配不均,是影响IC载板与电路板变形的凶手之一,想彻底解决这个问题可能得从热力学的角度下去研究,比如说板材玻璃纤维(Glass fiber)的方向是否可以增强变形抵抗能力,或是铜箔分配所造成的热效应等。
但温度分布不均的最大问题无非是升温速度太快,以致造成局部区域温度无法跟着环境温度上升,比如说大面积的铜箔处(容易吸热),还有大零件的地方,比如说智能卡读卡槽(Smart Card Reader)以及屏蔽罩(Shielding Can)的下方温度都不易上升,所以试着降低Reflow升温的速度(调低链条速度,或降低某些升温区的温度),都可以帮助板子的温度达到均匀化,但要小心不要让板子与零件所吸收的热能太过饱和,否则可能造成其他问题(脆化或起泡),建议要执行实验计划以得到最佳的温度曲线(temperature profile)。
另外,可以考虑采用「热阻焊垫或限热焊盘」设计以提升电路板升温的整体均匀性。
BGA IC预先烘烤
IC封装零件如果吸湿,在流经回焊炉(Reflow)时除了容易发生分层(delamination)的问题外,IC变型翘曲也是一大隐患,预先烘烤(105°C)可以逼出水气,降低过reflow时的变形量。增加电路板上BGA焊点的焊锡量
既然IC载板及电路板的板弯板翘会造成锡球与锡膏不接触,那么只要增加锡膏量(solder paste)应该就可以缩短锡膏与锡球的接触距离并增加接触面积,达到提高良率的目的。只是如何增加锡膏量是个值得探讨的问题的课题,而且BGA焊垫处的锡膏印刷量是没有办法能无限增加的,因为印多了可是会造成短路的,个人觉得并非所有的锡球焊点都要增加锡膏量,所以比较好的方法是只在变形量较大的地方增加就可以了。
下面是一个选择性的锡膏量增加的方法,根据统计有99%的HIP都只发生在BGA四周最外面一排的锡球上而已,所以我们只要把BGA最外圈的锡球焊垫增加锡量就可以了,我们的作法是把钢板开口开成方型的内切圆,其他的锡球还是维持圆型的开孔。
相关阅读:增加锡膏量可以改善BGA焊接不良?
下面是一个选择性的锡膏量增加的方法,根据统计有99%的HIP都只发生在BGA四周最外面一排的锡球上而已,所以我们只要把BGA最外圈的锡球焊垫增加锡量就可以了,我们的作法是把钢板开口开成方型的内切圆,其他的锡球还是维持圆型的开孔。
使用过炉载具(Carrier/template)
有些电路板可能因为设计限制,所以必须使用比较薄的板子,比如说1.2mm、1.0mm、0.8mm,请记住越薄的板子过回焊炉的变形量会越大,另外还有其他的原因可能造成板子变形:板子的尺寸越大也越容易造成变形。
板子上面有较重零组件时。
二次回焊的板子。
如果前面的方法都已经试过了,这时候使用过炉载具(carrier)或许已经是最后的手段,过炉载具利用定位柱及孔来支撑住电路板的板型尺寸,可以有效防止变形。虽然使用过炉载具可能所费不梓,还耗费人工,但如果跟HIP的缺点所造成的损失相比可能就微不足道了。
相关阅读:合成石过炉托盘(Reflow carrier)
采用高Tg的板材
Tg是玻璃转换温度,也就是材料由玻璃态转变成橡胶态的温度,Tg值越低的材料,表示其板子进入回焊炉后开始变软的速度越快,而且变成柔软橡胶态的时间也会变长,板子的变形量当然就会越严重。采用较高Tg的板材就可以增加其承受应力变形的能力,但是相对地材料的价钱也比较高。
WBGA的IC封装似乎较容易变形
上图显示这种WBGA的IC封装因为其先天结构的关系,似乎比较容易发生翘曲的变形问题,这个必须请IC厂商严格控管其IC的变形量。

编辑:admin 最后修改时间:2023-03-23


